9.1.3 BGA Component Reball Inspection
BGA reball inspection procedures to verify solder sphere alignment, size consistency and attachment integrity. Includes visual and measurement checks to ensure readiness for reinstallation.
Minimum Skill Level: Expert
Conformance Level: High
REQUEST FOR QUOTE GUIDES INDEX

BGA Component Reball Inspection

Crushed solder spheres. This is a reject condition.

Excessive flux and oxidation. This is a reject condition.

Substrate damage. This is a reject condition.
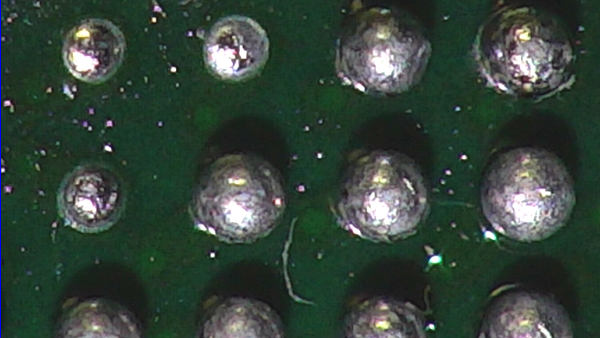
Missing solder spheres. This is a reject condition.

For help with BGA rework, contact the globally recognized authority, trusted by aerospace, defense, and electronics manufacturers.
LEARN MORE
SLIDESHOW STARTING
❮
❯













