9.2.1 BGA Component Rework Profile Development, Standard Method
Develop thermal profiles for BGA rework using standard thermocouple placement and ramp control methods. Covers preheat, soak and reflow parameters for safe component removal and attachment.
Minimum Skill Level: Advanced
Conformance Level: High
REQUEST FOR QUOTE GUIDES INDEX

BGA Component Rework Profile Development, Standard Method
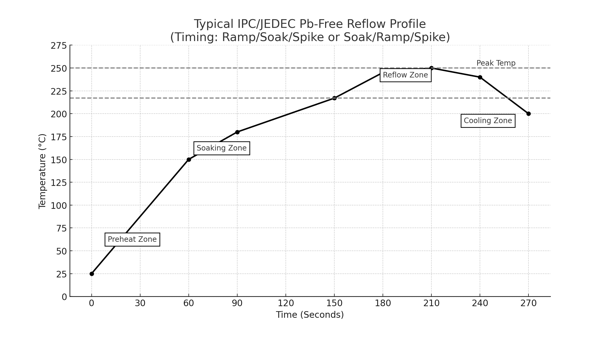
Sample time/temperature profile.

BGA component thermocouple locations

Thermocouple location within the solder ball.

For help with BGA rework, contact the globally recognized authority, trusted by aerospace, defense, and electronics manufacturers.
LEARN MORE
SLIDESHOW STARTING
❮
❯















